CMP (ChemicalMechanicalPolishing)化學機械拋光是一個化學腐蝕和機械摩擦(cā)的結合。是目前較為普遍(biàn)的(de)半導(dǎo)體材料表麵平整技術,兼收了機械摩擦和化學腐蝕的優點,從而避免了由單純機械拋光造成(chéng)的表麵損傷和由單純化(huà)學拋光(guāng)易造成的拋光速度慢、表麵平整度(dù)和拋(pāo)光一致性差等缺點。可以獲得比較完美的(de)晶片表麵。
國際上普遍認為,器件特(tè)征尺寸在0.35μm以下時,必須進行全局平麵化以保(bǎo)證光刻影像傳遞的精確度和分辨(biàn)率,而(ér)CMP是目前(qián)可以提供全局平(píng)麵化的技(jì)術。其設備作用原理(lǐ)圖(tú)如下(xià):
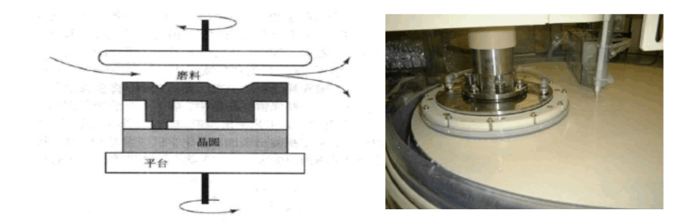
研磨液:研磨時添加(jiā)的液體狀物質,顆粒大小跟研磨後的刮傷(shāng)等缺陷有(yǒu)關,顆粒越大對晶片的損傷越大,顆粒越小越(yuè)好。基本形式是由納米粉體拋光劑和(hé)一個堿(jiǎn)性組分水溶液組成,顆粒的大小1-100nm,濃度1.5%-50%,堿性組成一般是KOH,氨或有機胺,pH為9.5-11。
由於氣相二氧化矽的高(gāo)純度、可控製的原始納米粒徑和(hé)粒徑分布等(děng),使得氣相sio2成為氧(yǎng)化物拋光研磨液中(zhōng)的主要磨料。
本(běn)項目經(jīng)過專有工藝生產的CMP氣矽對打破國外品(pǐn)牌對研磨液用氣矽的壟斷地位,對中國芯片全產業鏈的發展貢獻,具有十分重要意義。